在TOF-SIMS数据的解析过程中,通常需要将实测二次离子的质荷比与标准数据库中记录的原子离子或分子离子的精确质量数进行比对,以确定二次离子所对应的元素或分子结构。因此,准确的质量校准是TOF-SIMS数据处理中至关重要的一步。本期技术文章将介绍如何正确进行TOF-SIMS数据的质量校准。
TOF-SIMS质量校准原理
在TOF-SIMS分析中,质谱仪记录的原始信号为二次离子到达探测器所用的飞行时间及其信号强度。二次离子的质荷比是根据其飞行时间计算得出的。这一转换过程通常由采集软件自动完成,但原始数据中的谱峰位置可能存在偏差。若直接使用原始数据中的质荷比,将影响后续的谱峰识别。因此,在解析谱图之前,需对二次离子的质荷比进行校准,该过程称为质量校准(mass calibration)。
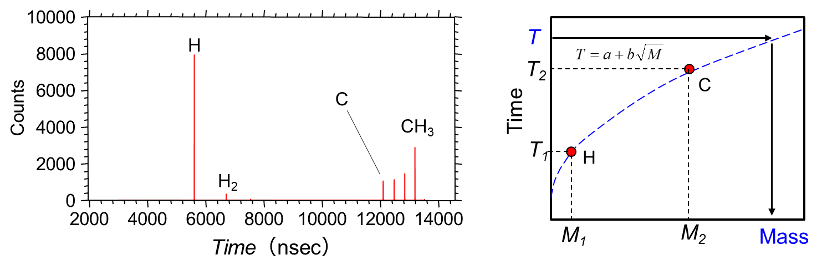 图1. TOF-SIMS质量校准原理
图1. TOF-SIMS质量校准原理
* 由于多价态二次离子难以脱离样品表面束缚进入质量分析器,TOF-SIMS分析过程中主要检测带一个单位正/负电荷的二次离子,因此,在解析数据时可将二次离子质荷比简称为二次离子质量。
图1展示了质量校准的基本原理与主要流程。质量数为M的二次离子在质谱仪中的总飞行时间T由两部分组成:一次离子到达样品表面的时间,以及二次离子从样品表面飞行至探测器的时间。前者由一次离子类型和加速电压决定,后者与二次离子质量M的平方根成正比,两者之间满足以下关系:

式中,a和b是两个常数。若已知两个二次离子的质量M及其对应的飞行时间T,即可通过最小二乘法拟合出a和b的值,从而建立任意二次离子飞行时间与质量数之间的关系。由于飞行时间与质量数之间为非线性关系,为减小校准偏差并提高质量精度,实际操作中通常需选用三个及以上已知离子对谱图进行校准。
质量校准的基本原则
在使用TOF-SIMS数据处理软件进行校准时,程序会根据所选校准谱峰自动完成上述计算,但需遵循以下基本原则以确保校准准确:
只能用已经知道分子式/元素的质谱峰来进行质量校准;
至少需要使用三个非H的质谱峰来校准谱图;
优先选择质量数较大,分布均匀的谱峰;
校准后各校准质谱峰的质量偏差应小于100 ppm。
国际标准ISO 13084:2018对TOF-SIMS数据质量校准提出更为具体的要求,被视为TOF-SIMS 领域 “质量标尺校准的基准方法” [1],主要内容包括:
由于样品表面粗糙度会影响质量分辨率,当样品表面粗糙度大于1 μm时,质量校准精度会变差;
不建议使用氢离子进行校准,因为氢离子飞行时间受磁场干扰较大
识别分子离子时,避免使用原子离子进行校准;
最大校准峰的质量数应超过所分析谱峰质量的55%(例如识别1000 amu的谱峰时,应使用高于550 amu的校准峰);
校准谱峰数量并不是越多越好,应控制在5个以内。
校准谱峰选择
在校准时,我们需要结合样品成分信息,选择合适的谱峰对数据进行质量校准。通常在大部分样品表面都会检测到碳氢化合物的信号,这类物质极易吸附在样品表面,且二次离子产额较高,因此,在大部分情况下,推荐使用碳氢化合物系列谱峰对TOF-SIMS数据进行校准:
正离子模式下:CH3+/C2H3+/C3H5+/C4H7+等
负离子模式下:CH-/C2H-/C4H-/C6H-等
当然,并不是所有的数据都可以使用碳氢化合物系列谱峰进行校准,当这类组分信号比较弱时,也可以选择信号较强的特征二次离子峰来进行质量校准。例如,在循环后的锂电材料通常会检测到较强的LiF类组分信号(正离子模式下:Li2F+/Li3F2+/Li4F3+等;负离子模式下:LiF2-/Li2F3-/Li4F3-等),这时也可以用这类谱峰进行校准。此外,一些样品表面容易电离的污染物组分,如碱金属离子(Li+/Na+/K+/Cs+)和卤族组分(F-/Cl-/Br-/I-),也可以用于质量校准。
另外,同一个样品的校准谱峰也不是一成不变的。样品需同时进行表面分析和深度分析,且成分随深度变化,则表面谱与深度累积谱可能需采用不同的校准峰,应根据实际成分和谱图特征灵活调整。
软件操作:TOF-DR质量校准步骤
TOF-SIMS数据通常需要使用专用的数据处理软件来进行质量校准,图2展示了PHI TOF-SIMS数据处理软件TOF-DR的质量校准界面与操作流程:
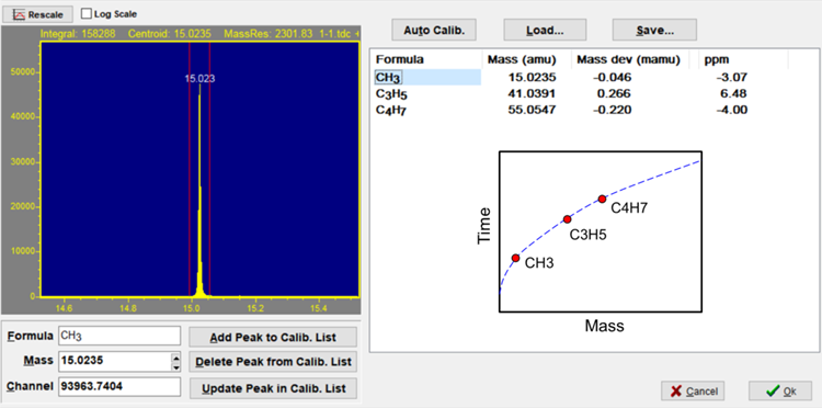
图2. TOF-DR质量校准界面
1.打开待校准的质谱数据,点击“Calibrate”按钮,进入如图所示的校准界面;
2.添加/删除校准谱峰
·添加:在“Formula”一栏中输入想要添加的二次离子化学式,并以空格或“+”隔开元素,之后点击“Add Peak to Calib. List”按钮;例如,添加C4H7+时,请输入C4+H7;
·删除:在界面右侧选中想要删除的谱峰,并点击“Delete Peak from Calib. List”按钮进行删除;
3.确认校准谱峰位置
·在界面右侧选中待校准谱峰,使用双光标调整校准列表中每个谱峰的左右两侧积分区间,逐个确定谱峰位置是否正确,并按下“Update Peak in Calib. List”按钮;
4.评估校准结果
在确认每个校准谱峰的峰位置与积分区间后,软件会自动计算校准后的谱峰偏差,并显示校准结果。图2右侧展示的是质量校准的相关参数,分别为:
Formula:校准谱峰;
Mass (amu):校准谱峰的实测质量值;
Mass dev (mamu):校准谱峰实测质量值与理论值的绝对偏差,单位mamu;
ppm:校准谱峰实测质量值与理论值的相对偏差,即绝对偏差/谱峰理论精确质量,单位ppm。
在完成步骤1-3之后,我们需要根据质量偏差评估校准结果是否达标。对于表面平整的样品,通常我们会选择质量数小于100 amu的3个谱峰进行校准,校准后绝对质量偏差应小于1 mamu,相对质量偏差应小于100 ppm。
但在实际测试中,这个评价标准并非绝对的。对于表面凹凸不平或导电性较差、测试过程荷电效应较为严重的样品,所采集的质谱数据质量分辨率通常较差,谱峰拖尾也会比较严重,这时即使我们做了正确的质量校准,校准后的质量偏差也很难控制在1 mamu和100 ppm以内。在分析这类校准后质量偏差较大的质谱数据时,不能完全依赖于数据库质量数比对来解析谱峰,需要结合谱峰出峰规律、同位素丰度比以及其他辅助信息来进行谱峰识别。
小结
质量校准是TOF-SIMS数据处理中的关键步骤,校准准确性直接影响谱峰识别的可靠性,但是错误校准将导致后续解析失败。因此,TOF-SMS数据分析时须严格遵循规范流程,确保校准准确,为深入的数据分析奠定坚实基础。
参考文献
[1] ISO 13084:2018 Surface chemical analysis — Secondary-ion mass spectrometry — Calibration of the mass scale for a time-of-flight secondary-ion mass spectrometer [S]. Geneva: International Organization for Standardization, 2018.









